機械・システム
次世代以降向けマスク描画・修正技術 - 50nm線幅プローブリソで数百倍の描画耐久性向上を実現 -
2012年7月
概要
当社は、技術研究組合BEANS研究所および東京大学と共に、線幅16nm~11nmの次世代以降の半導体向けマスク描画・修正技術として、数10nm級の微細加工ができるマイクロプローブ技術を開発しました。プローブと被接触面との摩耗が発生しても電気的な機能を維持できる構造を採用しています。試作したプローブの耐久性は、従来比で数100倍を実現しました。本成果は、中国の南京で開催された国際学会IEEE/APCOT2012で発表しました。なお、今回の研究開発の一部は、NEDOが委託した「BEANSプロジェクト:異分野融合型次世代デバイス(Bio Electromechanical autonomous Nano systems)製造技術開発プロジェクト」の一環として実施したものです。
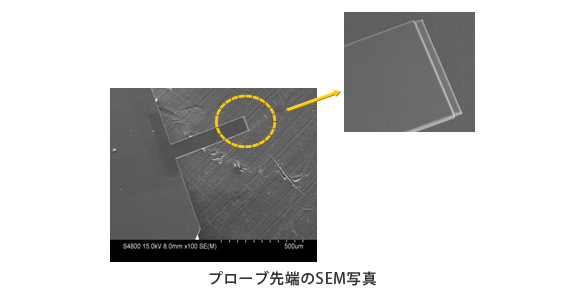
開発の背景
現在マスク描画・修正技術として利用されている光リソグラフィは、高価なマスクが必要です。また、光の回析限界により加工の限界が近づいています。電子ビームを利用した電子ビームリソグラフィでは、より微細な加工及びマスクの作製・修正ができますが、装置のコストが高額です。プローブリソグラフィ技術は、先端を鋭利に尖らせたプローブの先端を基板に接触させ、電圧を印加して、電気化学反応で加工・描画します。微細なパターンを加工・描画でき、装置コストの面で優位性があります。しかし、プローブの使用回数が増えると先端が磨耗してしまうことと、加工・描画のスループットが非常に遅いことが課題でした。
本技術の特長
そこで、当社は、プローブ先端に庇部と接触部を設け、接触部はマイクロスケールの機械的な接触部とナノスケールの電気的な接触部を有する構造を採用したプローブリソグラフィ技術を開発しました。耐久性は、従来比で数100倍です。機械的な接触部と電気的な接触部を同時に描画基板に接触させ、電極部膜質を改善して耐久性の向上をはかりました。また、プローブ先端に庇構造を導入し、ウエハレベルでの加工性を向上させ、スループット向上につながる多数本を備えたマルチ・プローブ量産性向上の可能性を示しました。
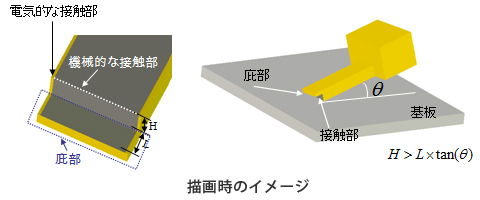
今後の展望
プローブリソグラフィ技術を次世代マスク描画・修正技術の候補の一つとして、更なる耐久性向上とスループット向上を目指し、実用化を目指して研究開発を進めていきます。また、遺伝子評価装置の検査部やHDDのヘッド部分への適用に向けても開発を進めていきます。


